波動を研究する 白崎研究所
研究紹介schedule
スキャトロメトリ
光波を用いたScatterometry(光波散乱計測)は、白崎教授の長年の研究によって世界でも最先端のノウハウを蓄積してきました。 この技術を活用して、光波による3次元断面形状計測装置の製作を行い、先端分野における新技術開発のために貢献します。
ムーアの法則は、「LSIに集積可能なトランジスタの数は、約1.5年で2倍に増える」という技術開発スピードに関する経験則です。 半導体のための2014年のインターナショナル・テクノロジー・ロードマップによれば、2015年現在の22ナノメートルから、2024年に8ナノメートルの線幅計測が必要となります。
さらに集積回路製作では、ウェハーサイズの大口径化による面内ばらつきの増加や、新材料の適用による不良要因の増加による非生産ウェハーを減らすことが重要です。 しかし線幅が、光の波長の数分の一になる場合には、顕微鏡で検査する事はもはや出来ません。この断面形状測定を非破壊非接触で行う方法として、光波を用いたスキャトロメトリ(Scatterometry:光波散乱計測)があります。 スキャトロメトリの基本は、光波長帯域における反射光のライン&スペース繰り返しパターン形状依存特性を数値解析より求め、実測値との比較よりパターン形状を求める方法です。

さらに集積回路製作では、ウェハーサイズの大口径化による面内ばらつきの増加や、新材料の適用による不良要因の増加による非生産ウェハーを減らすことが重要です。 しかし線幅が、光の波長の数分の一になる場合には、顕微鏡で検査する事はもはや出来ません。
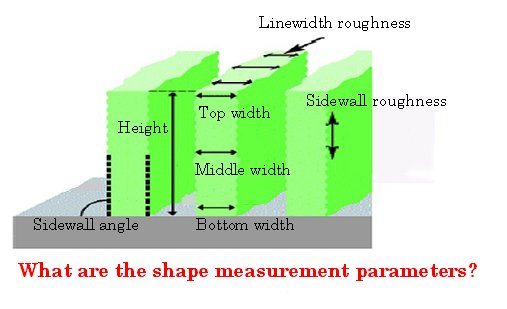
この断面形状測定を非破壊非接触で行う方法として、光波を用いたScatterometry(光波散乱計測)があります。 スキャトロメトリの基本は、光波長帯域における反射光のライン&スペース繰り返しパターン形状依存特性を数値解析より求め、実測値との比較よりパターン形状を求める方法です。
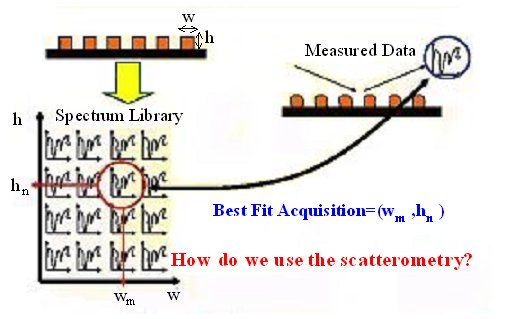
測定法には、垂直入射法と斜め入射法があります。
これは、薄膜の膜厚や材料定数を調べるReflectometry(垂直入射)とEllipsometry(斜め入射)に対応しています。
本研究では、トレンチホールなど、3次元形状の測定を行います。

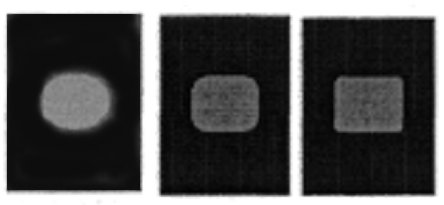
光波散乱の電磁界解析手法は、次の2通りです。
?RCWA(Rigorous Coupled Wave Analysis)
?FDTD法(Finite Difference Time Domain Method)
この技術は、scatterometryだけでなく、色んな分野で応用できます。 詳細については、気軽にお問い合わせください。 誠意をもって、ご説明させていただきます。
| 0,000,072,961 |
Yesterday: 45
Today: 36
